Lastwechselprüfplätze für Leistungshalbleiter
Thermomechanische Lebensdauerqualifizierung Ihrer Leistungsmodule
Übersicht
70 % aller Leistungsmodul-Ausfälle gehen auf Bond-Draht-Degradation zurück — ein Bauteil, das weniger als einen Cent kostet. Ein Lastwechselprüfplatz (Power Cycling Test Station) findet diese Schwachstellen, bevor sie im Feld auftreten.
Durch zyklisches Einprägen eines Laststroms und anschließendes Abschalten entstehen periodische Temperaturschwankungen (ΔTj) an der Sperrschicht des Halbleiters. Der CTE-Mismatch zwischen Silizium (2,6 ppm/K), Aluminium-Bonddraht (23 ppm/K) und Kupfer (17 ppm/K) erzeugt bei jedem Zyklus Scherspannungen an den Grenzflächen. Die typischen Ausfallmechanismen: Bond-Draht-Abheben (Bond Wire Lift-off), Rissbildung an der Chipmetallisierung, Degradation der Lotverbindung (Solder Fatigue) und kaskadierende Rückkopplung — ein Lötriss erhöht Rth, die Sperrschichttemperatur steigt, der Bond-Stress wächst, bis eine Kaskade zum Totalausfall führt.
Die ECPE-Richtlinie AQG 324 definiert zwei Lastwechseltest-Modi und verfolgt ein Test-to-Failure-Prinzip — nicht Pass/Fail bei fester Zyklenzahl, sondern Erzeugung von Ausfallwissen:
- PCsec (ton < 5 s): Kurze Heizpulse belasten primär Bond-Drähte und Chipmetallisierung
- PCmin (ton > 15 s): Längere Heizzeiten prüfen Lotschichten und Gehäuseanbindung
Wer nur einen der beiden Tests durchführt, übersieht die Hälfte der möglichen Versagensmoden. Das End-of-Life-Kriterium nach AQG 324: +20 % Rth oder +5 % VCE(sat).
SiC-Module stellen besondere Anforderungen: Höhere Betriebstemperaturen (175-200°C) und steilere Temperaturgradienten erzeugen mehr thermomechanischen Stress pro Zyklus. Moderne Verbindungstechnologien wie Silber-Sintern und Copper-Clips erreichen bis zu 29-fach höhere Lebensdauer gegenüber konventionellem Löten.
Schuster Elektronik fertigt Lastwechselprüfplätze für den gesamten Leistungsbereich:
- Lastströme von 150 A bis 1.000 A
- Bis zu 36 Prüfplätze pro System
- Automatische Rth-Messung mit VCE(T)-Methode
- Qualifizierung nach AQG 324 (PCsec und PCmin)
- Geeignet für Si-IGBT, Si-MOSFET, SiC-MOSFET, Dioden und Thyristoren
- Netzwerk-Schnittstelle für Fernüberwachung
Unsere Lastwechselprüfplätze
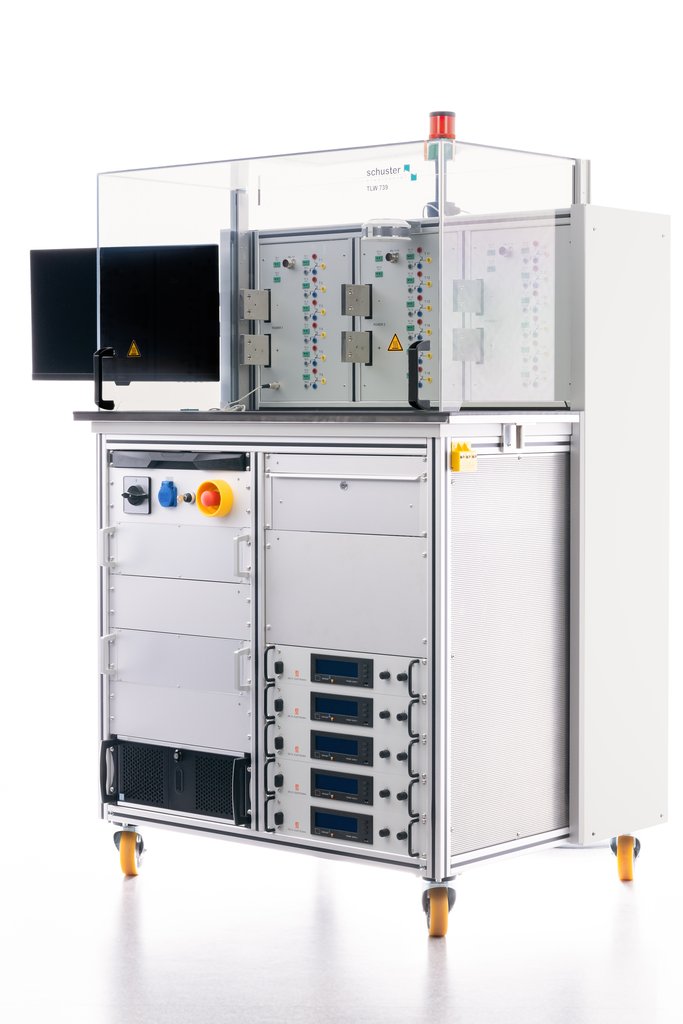
TLW 739
TESTSYSTEM FÜR LASTWECHSELFESTIGKEIT VON HALBLEITERMODULEN

TLW 763
TESTSYSTEM FÜR LASTWECHSELFESTIGKEIT VON HALBLEITERMODULEN
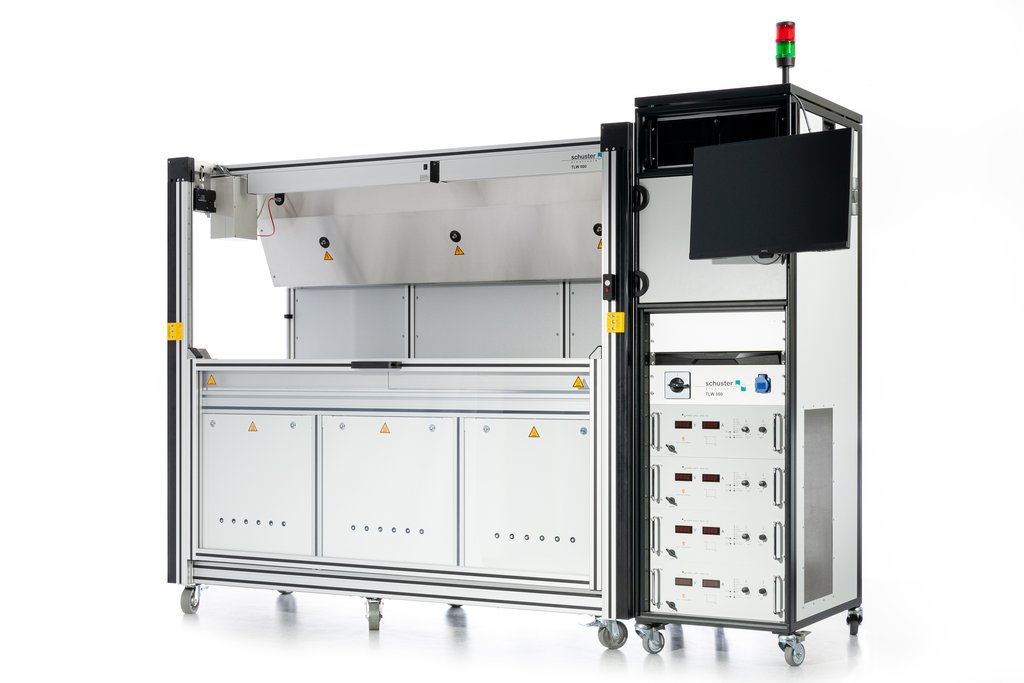
TLW 800
TESTSYSTEM FÜR LASTWECHSELFESTIGKEIT VON HALBLEITERMODULEN

TLW 813
TESTSYSTEM FÜR LASTWECHSELFESTIGKEIT VON HALBLEITERN
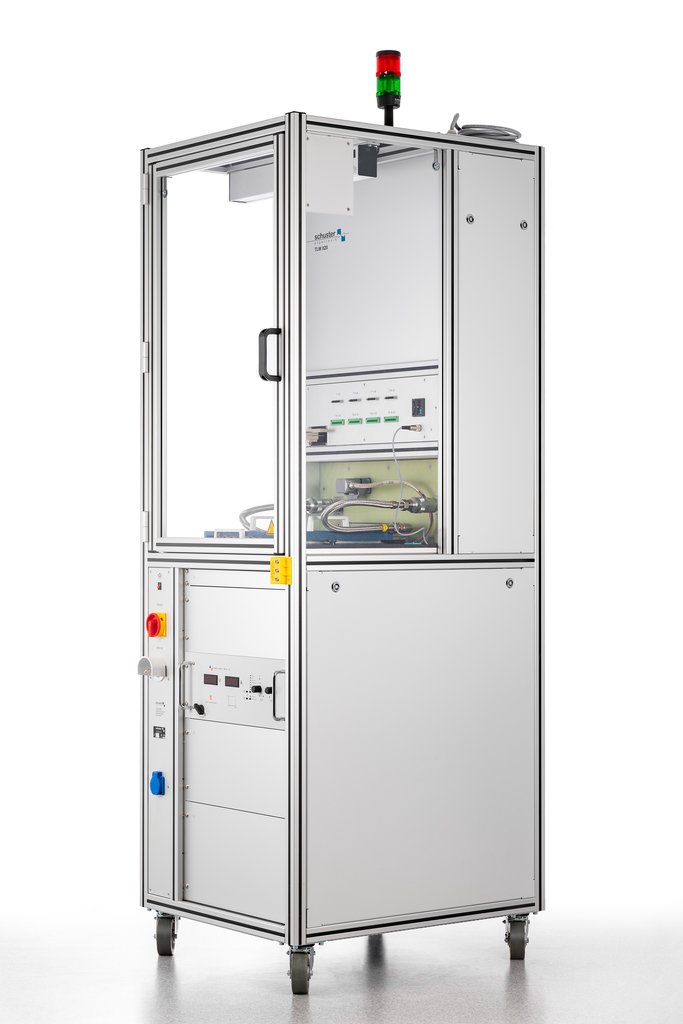
TLW 820
TESTSYSTEM FÜR LASTWECHSELFESTIGKEIT VON HALBLEITERMODULEN
Häufig gestellte Fragen
01 Was genau passiert bei einem Lastwechseltest und welche Ausfallmechanismen werden damit provoziert?
Beim aktiven Lastwechseltest (Active Power Cycling) wird der Prüfling durch seinen eigenen Durchlassstrom periodisch aufgeheizt und in der Abkühlphase über ein Kühlsystem wieder abgekühlt. Die dabei entstehenden zyklischen Temperaturhübe (ΔTj) erzeugen thermomechanische Spannungen an den Grenzflächen zwischen Materialien mit unterschiedlichen Wärmeausdehnungskoeffizienten. Die typischen Ausfallmechanismen sind:
- Bond-Draht-Abheben (Bond Wire Lift-off): Durch die unterschiedliche Wärmeausdehnung von Aluminium-Bonddraht und Chipoberfläche entstehen Scherspannungen, die zur Ablösung der Bondverbindung führen. Manifestiert sich als Anstieg der Durchlassspannung VCE(sat).
- Chipmetallisierungs-Degradation: Rekristallisation und Rissbildung in der Aluminium-Metallisierung auf dem Chip, beschleunigt durch hohe Temperaturschwankungen.
- Lotschicht-Ermüdung (Solder Fatigue): Rissfortschritt in der Lötverbindung zwischen Chip und DCB-Substrat (Die Attach) sowie zwischen Substrat und Bodenplatte. Manifestiert sich als Anstieg des thermischen Widerstands Rth(j-c).
02 Was unterscheidet PCsec von PCmin nach AQG 324 und wann wird welcher Modus eingesetzt?
Die ECPE-Richtlinie AQG 324 definiert zwei unterschiedliche Lastwechsel-Modi, die gezielt unterschiedliche Ausfallmechanismen adressieren:
- PCsec (ton < 5 s): Kurze Heizpulse erzeugen steile Temperaturgradienten, die primär die chipnahen Verbindungen belasten -- Bond-Drähte, Chipmetallisierung und die obere Lotschicht (Die Attach). Dieser Modus simuliert Anwendungen mit schnellen Lastwechseln wie Motorumrichter.
- PCmin (ton > 15 s bis Minuten): Längere Heizzeiten lassen die Wärme tief in die Aufbaustruktur eindringen. Die thermische Belastung verteilt sich bis in Substrat, Baseplatte-Lötung und Gehäuseanbindung. Dieser Modus ist relevant für Anwendungen mit langsameren Lastzyklen.
Die End-of-Life-Kriterien nach AQG 324: +5 % Anstieg VCE(sat) oder +20 % Anstieg Rth gegenüber dem Anfangswert.
03 Wie wird die Sperrschichttemperatur im Lastwechseltest gemessen?
Die Standardmethode ist die VCE(T)-Methode (auch TSEP-Methode -- Temperature Sensitive Electrical Parameter). Dabei wird der Halbleiter selbst als Temperatursensor genutzt:
- Kalibrierkurve: Vor Testbeginn wird die temperaturabhängige Durchlassspannung VCE bei einem definierten Messstrom (typisch 1-500 mA) für verschiedene Temperaturen aufgenommen.
- Messung im Test: Nach jedem Lastzyklus wird der Laststrom abgeschaltet und ein kleiner Messstrom eingeprägt. Die gemessene Durchlassspannung wird über die Kalibrierkurve in die virtuelle Sperrschichttemperatur Tvj umgerechnet.
- Zth-Bestimmung: Aus dem Abkühlverlauf Tvj(t) kann die transiente thermische Impedanz Zth(t) berechnet werden -- ein empfindlicher Indikator für beginnende Lotschichtdegradation, bevor sich der stationäre Rth messbar verändert.
Bei SiC-MOSFETs ist zu beachten, dass sich die Kalibrierkurve je nach Gate-Bias-Bedingung (VGS = 0 V vs. VGS = -10 V) unterschiedlich verhält und durch Alterung verschieben kann.
04 Welche besonderen Anforderungen stellen SiC- und GaN-Module an den Lastwechseltest?
Wide-Bandgap-Halbleiter unterscheiden sich in mehreren Aspekten von konventionellen Si-IGBTs:
- Höhere Betriebstemperaturen: SiC-Module können bei Sperrschichttemperaturen bis 200°C und darüber qualifiziert werden. Das Prüfsystem muss diese Temperaturen zuverlässig messen und regeln.
- Andere Aufbautechnologien: Moderne SiC-Module verwenden oft gesinterte Chipanbindungen (Silber-Sinter statt Lot) und Kupfer-Bonddraht statt Aluminium. Diese Verbindungstechnologien haben andere Ermüdungscharakteristiken und erfordern angepasste Testparameter.
- Kleinere Chipflächen: Bei gleicher Stromtragfähigkeit sind SiC-Chips deutlich kleiner als Si-IGBTs, was zu höheren lokalen Wärmestromdichten führt.
- Kalibrierkurven-Stabilität: Bei SiC-MOSFETs kann sich die VCE(T)-Kalibrierkurve durch Gate-Oxid-Alterung verschieben (Threshold Voltage Drift), was die Temperaturmessung beeinflusst.
05 Welche Messinfrastruktur bieten die Schuster Elektronik Lastwechselprüfplätze?
Unsere Systeme bieten eine vollständige Messinfrastruktur für normgerechte Power-Cycling-Tests:
- Laststromerzeugung: 150 A (TLW 820 LoPo) bis 1.000 A (TLW 763), konfigurierbar auf Modulanforderungen
- Messstromquelle: bis 1.000 mA für die VCE(T)-Methode, inklusive automatischer Kalibrierkurvenermittlung
- Prüfplätze: bis zu 36 Messstellen in 3 unabhängigen Strängen (TLW 800), bis zu 20 Prüfplätze in einem Strang (TLW 820)
- Temperaturmessung: Thermoelemente Typ K an jedem Prüfplatz plus Strangtemperaturen
- Kühlung: Individuell regelbare Kühlkreisläufe (Wasser) je Strang mit PT100-Sensorik
- Optional: Aufzeichnung von Abkühlkurven und transiente Zth-Messung
- Datenmanagement: SPS-gesteuerter Dauerbetrieb mit automatischer Aufzeichnung, E-Mail-Benachrichtigung bei Testunterbrechungen, Netzwerk-Schnittstelle für Remote-Zugriff
- Sicherheit: Schutzhaube mit Sicherheitszuhaltung, automatische Grenzwertüberwachung
Anfrage zu Lastwechselprüfplatz
Sie interessieren sich für Produkte oder Neuheiten aus dem Bereich Lastwechselprüfplatz? Kontaktieren Sie uns — wir beraten Sie gerne.