Unsere Messgeräte & Prüfsysteme
Innovative Messtechnik für Leistungshalbleiter seit 1960
Gerätekategorien

Labor
Kennlinienmessgeräte - wenn es um mehr als nur einen Datenblatt-Wert geht.

Produktion
Messtechnik - unser Maßstab ist nicht das, was technisch machbar ist, sondern das, was für die Produktion sinnvoll ist. Praxistaugliche Lösungen für anspruchsvolle Messaufgaben von nA und µV bis kA und kV.

Qualitätssicherung
Die Produktqualität ist heute das Maß der Dinge und deren Nachweis oft ein wesentliches Verkaufsargument. Wir liefern die Werkzeuge zur Prüfung der Lebensdauererwartung Ihrer Module - Lastwechselzyklen und Hochtemperatursperrlagerung, parametrierbar und fernbedienbar, passend auch für Ihre Technologie.

Lastwechselprüfplatz
**70 % aller Leistungsmodul-Ausfälle** gehen auf Bond-Draht-Degradation zurück — ein Bauteil, das weniger als einen Cent kostet. Ein Lastwechselprüfplatz (Power Cycling Test Station) findet diese Schwachstellen, bevor sie im Feld auftreten. Durch zyklisches Einprägen eines Laststroms und anschließendes Abschalten entstehen periodische Temperaturschwankungen (ΔTj) an der Sperrschicht des Halbleiters. Der CTE-Mismatch zwischen Silizium (2,6 ppm/K), Aluminium-Bonddraht (23 ppm/K) und Kupfer (17 ppm/K) erzeugt bei jedem Zyklus Scherspannungen an den Grenzflächen. Die typischen Ausfallmechanismen: **Bond-Draht-Abheben (Bond Wire Lift-off)**, **Rissbildung an der Chipmetallisierung**, **Degradation der Lotverbindung (Solder Fatigue)** und **kaskadierende Rückkopplung** — ein Lötriss erhöht Rth, die Sperrschichttemperatur steigt, der Bond-Stress wächst, bis eine Kaskade zum Totalausfall führt. Die ECPE-Richtlinie **AQG 324** definiert zwei Lastwechseltest-Modi und verfolgt ein **Test-to-Failure-Prinzip** — nicht Pass/Fail bei fester Zyklenzahl, sondern Erzeugung von Ausfallwissen: - **PCsec** (ton < 5 s): Kurze Heizpulse belasten primär Bond-Drähte und Chipmetallisierung - **PCmin** (ton > 15 s): Längere Heizzeiten prüfen Lotschichten und Gehäuseanbindung Wer nur einen der beiden Tests durchführt, übersieht die Hälfte der möglichen Versagensmoden. Das End-of-Life-Kriterium nach AQG 324: **+20 % Rth** oder **+5 % VCE(sat)**. **SiC-Module** stellen besondere Anforderungen: Höhere Betriebstemperaturen (175-200°C) und steilere Temperaturgradienten erzeugen mehr thermomechanischen Stress pro Zyklus. Moderne Verbindungstechnologien wie Silber-Sintern und Copper-Clips erreichen bis zu **29-fach höhere Lebensdauer** gegenüber konventionellem Löten. Schuster Elektronik fertigt Lastwechselprüfplätze für den gesamten Leistungsbereich: - Lastströme von 150 A bis 1.000 A - Bis zu 36 Prüfplätze pro System - Automatische Rth-Messung mit VCE(T)-Methode - Qualifizierung nach AQG 324 (PCsec und PCmin) - Geeignet für Si-IGBT, Si-MOSFET, SiC-MOSFET, Dioden und Thyristoren - Netzwerk-Schnittstelle für Fernüberwachung

HTRB, HTGB, H3TRB
HTRB-, HTGB- und H3TRB-Tests gehören zu den wichtigsten Zuverlässigkeitsprüfungen in der Qualifizierung von Leistungshalbleitern. Die drei Tests sind **komplementär** — jeder deckt einen anderen Bauteilbereich ab. Wer nur einen durchführt, testet nur ein Drittel der möglichen Ausfallmechanismen. ### HTRB — Sperrschicht-Integrität unter Hochspannung **High Temperature Reverse Bias** belastet den Prüfling mit Sperrspannung (80–100 % VRRM) bei 150–175 °C über 1.000 Stunden. Der Test beschleunigt die thermisch aktivierte Degradation nach dem Arrhenius-Modell und deckt auf: - **Ionenmigration** — mobile Ionen (Na⁺, K⁺) wandern unter dem elektrischen Feld durch das Oxid und verändern die Oberflächenladung - **Kristalldefekte und Dislokationen** — führen unter Hochtemperatur-Sperrspannung zu erhöhtem Leckstrom - **Randabschluss-Degradation** — Defekte in Guard Rings, JTE und Field Plates an der Chipkante - **Passivierungs-Alterung** — unter dem kombinierten Stress aus hoher Temperatur und hohem elektrischem Feld Bei SiC-Bauteilen kann der Sperrstrom zunächst ansteigen und sich dann stabilisieren — ein Phänomen, das bei Silizium nicht auftritt. Die AQG 324 empfiehlt daher eine **Trendanalyse** statt starrer Grenzwerte. ### HTGB — Der kritischste Test für SiC **High Temperature Gate Bias** legt die maximale Gate-Spannung bei 150–175 °C an und prüft: - **Gate-Oxid-Integrität** — hält das Oxid der dauerhaften Feldbelastung stand? - **Schwellspannungsdrift (ΔVth)** — verschiebt sich die Einschaltschwelle? - **Ladungsträgerinjektion (Charge Trapping)** — sammeln sich Ladungen an der Oxid-Halbleiter-Grenzfläche? - **Zeitabhängiger dielektrischer Durchbruch (TDDB)** — wann bricht das Oxid durch? Bei SiC-MOSFETs ist HTGB besonders kritisch: Die SiC/SiO₂-Grenzfläche hat eine **100- bis 1.000-fach höhere Defektdichte** als Si/SiO₂. Kohlenstoffatome aus dem Substrat erzeugen Elektronenfallen, die Ladungsträger einfangen und die Schwellenspannung verschieben. Ein SiC-MOSFET mit Vth = 3,5 V bei Raumtemperatur kann nach 1.000 h HTGB bei 2,0 V oder 5,0 V einschalten — zu niedrig bedeutet Fehleinschaltung und Shoot-Through, zu hoch bedeutet erhöhter Durchlasswiderstand. HTGB muss in **beiden Polaritäten** durchgeführt werden: Positive Spannung treibt Elektronen-Trapping, negative Spannung treibt Loch-Trapping. Wer nur eine Polarität testet, sieht nur die halbe Wahrheit. ### H3TRB — Wenn Feuchtigkeit zur Waffe wird **High Humidity High Temperature Reverse Bias** kombiniert Sperrspannung mit 85 °C und 85 % r.F. über 1.000 Stunden. Die Kombination aus Temperatur, Feuchtigkeit und elektrischem Feld treibt elektrochemische Korrosion im Inneren des Bauteils an: - **Dendritenwachstum** — metallische Whisker wachsen unter Feuchtigkeit und E-Feld zwischen Leitern und erzeugen Kurzschlüsse. Ohne Vorwarnung, ohne Parameterabdrift. - **Elektrochemische Migration** — Metallionen (Ag, Cu) wandern entlang von Oberflächen - **Passivierungs-Integrität** — Risse oder Poren lassen Feuchtigkeit zum Chip vordringen H3TRB ist kein reiner Package-Test: Besonders bei SiC, wo die Passivierung häufig dünner ist, kann die Kombination aus Feuchtigkeit und hoher Sperrspannung auch die Chipoberfläche angreifen. Seit der **AEC-Q101-Revision 2024** gilt die tatsächliche Nennspannung statt des alten 100-V-Limits. ### DHTRB — Dynamische Prüfung für SiC und GaN **Dynamic Reverse Bias** — seit AQG 324 Release 04.1/2025 Pflicht für SiC-Module im Automotive-Bereich. Ein SiC-MOSFET im Traktionswechselrichter schaltet 100.000- bis 500.000-mal pro Sekunde. Während des gesamten statischen HTRB-Tests schaltet das Bauteil kein einziges Mal. DHTRB ersetzt die statische Gleichspannung durch gepulste Spannungsprofile bis 500 kHz mit einstellbarem Duty Cycle (25–75 %). Dynamisches Schalten erzeugt vier Belastungsarten, die ein statischer Test vollständig verpasst: - **Magnetfeldinduzierte Bondkräfte** — steile di/dt-Flanken üben mechanische Kräfte auf Bonddrähte aus - **Dielektrische Ermüdung** — wiederholte Spannungswechsel verursachen Trap-Bildung am Gate-Oxid - **Beschleunigte Elektromigration** — dynamische Profile treiben Wanderungsprozesse an Materialübergängen - **Lokales Self-Heating** — Schaltflanken erzeugen thermomechanische Mikrozyklen ### Normen und Standards - **JEDEC JESD22-A108** — Referenznorm für HTRB weltweit - **IEC 60749-23** — Internationale Norm für Hochtemperatur-Sperrspannungstests - **AQG 324 (ECPE)** — Pflicht für Automotive-Leistungsmodule: HTRB (QL-05), HTGB (QL-06), H3TRB (QL-07) plus dynamische Varianten (DHTRB, DGS, dyn-H3TRB) für SiC - **AEC-Q101** — Automotive-Qualifizierung für diskrete Halbleiter - **MIL-STD-750** — Anforderungen für Raumfahrt und Verteidigung ### Das HTRB 689 von Schuster Elektronik - Prüfspannung bis ±2.000 V (Si, SiC, GaN) - 18 Einzelprüflinge oder 9 Halbbrücken-Module pro Station - Sperrstrommessung bis 300 mA pro Kanal - Temperaturmessung bis 200 °C direkt an der Prüflings-Bodenplatte - Modular erweiterbar auf über 10 Stationen - Drei Betriebsarten für die Spannungserzeugung (verschiedene Welligkeitsmodi) - Automatische Grenzwertüberwachung mit sofortiger Abschaltung - Unabhängige Gate-Spannungsquellen pro Kanal für kombinierte HTRB/HTGB-Tests - Netzwerk-Schnittstelle für Remote-Monitoring und Datenexport
Unser Produktkatalog
Zeige 46 Produkte
Messgeräte nach Verwendungsziel
Messysteme
Messgeräte nach Messgrößen

BVM 625
SPERRSPANNUNGSMESSGERÄT

BVM 729
BVM 729 Kennlinienmessgerät

BVM 738
SPERRSPANNUNGSTESTER FÜR LEISTUNGSHALBLEITER

DM 659
DM 659 Durchlass-Kennlinienmessgerät

DM 678
DURCHLASSMESSGERÄT UND MESSSTELLENUMSCHALTER

DM 714
DURCHLASSMESSGERÄT

DM 725
DURCHLASSMESSGERÄT

DM 736
DURCHLASSMESSGERÄT

DM 821
DURCHLASSMESSGERÄT

DQA 775
DURCHLASS-, GATE-LADUNGS-, UND AVALANCHE-MESSGERÄT

DT 616
DT 616 Diodenprüfgerät

DTS 761
TESTSYSTEM FÜR DYNAMISCHE EIGENSCHAFTEN VON LEISTUNGSHALBLEITERN

DVDT 736
PRÜFGERÄT FÜR dv/dt – VERHALTEN VON THYRISTOREN

FVM 625
DURCHLASSMESSGERÄT

GSG 664
GATE-STRESS-GENERATOR
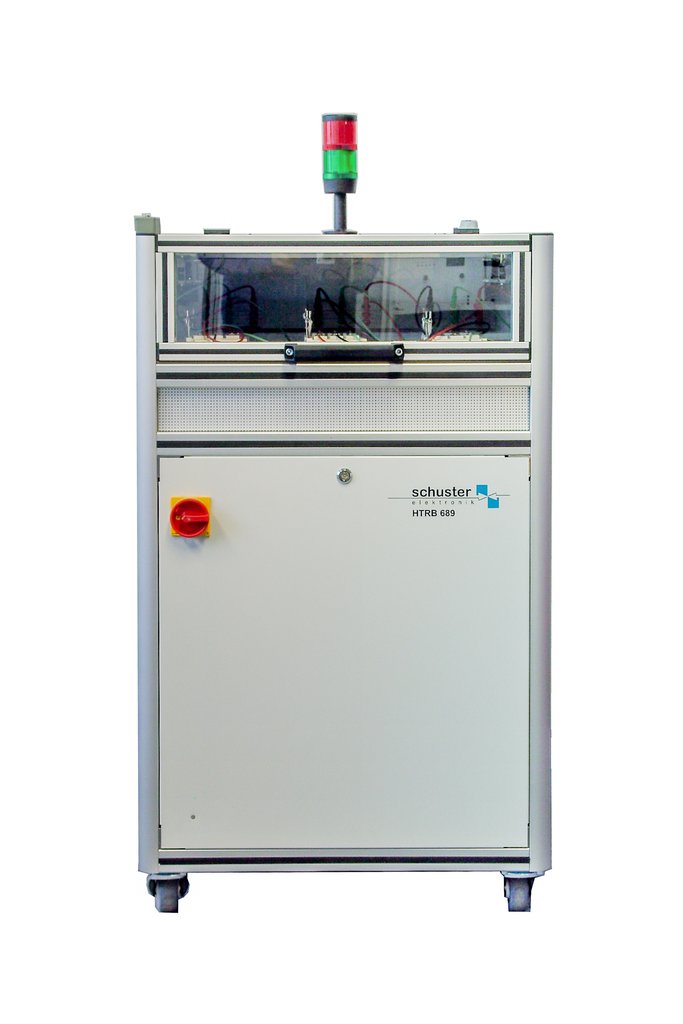
HTRB 689
PRÜFANLAGE FÜR HOCHTEMPERATUR-SPERR-LAGERUNG

HTRB 782
PRÜFANLAGE FÜR HOCHTEMPERATURSPERRLAGERUNG
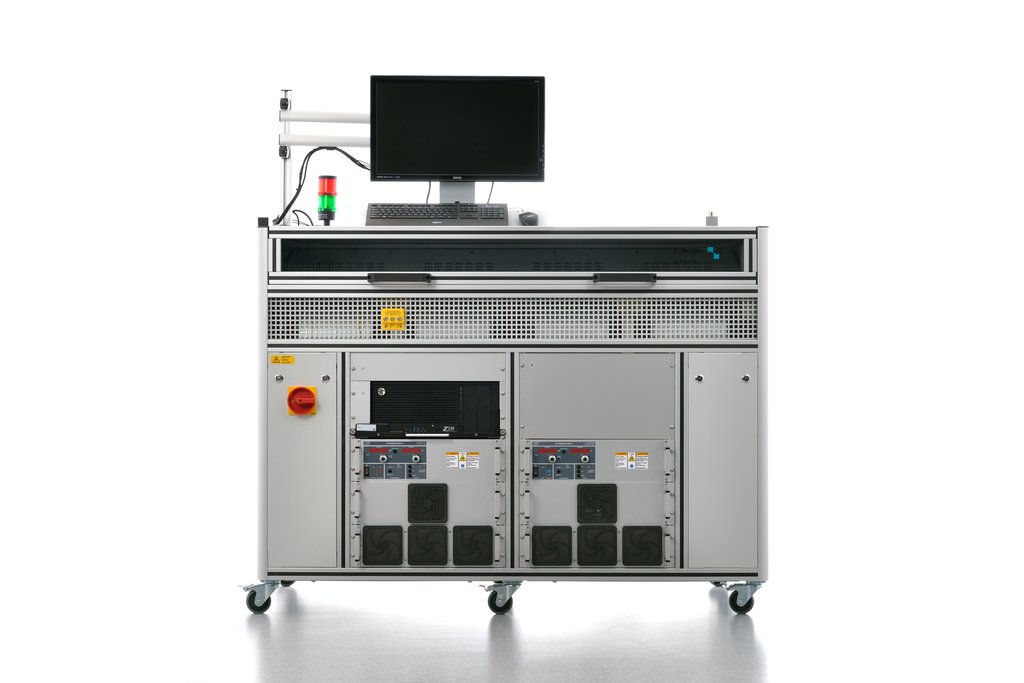
HTRB 784
PRÜFANLAGE FÜR HOCHTEMPERATURSPERRLAGERUNG

IP 625
ISOLATIONSPRÜFGERÄT

IP 630
ISOLATIONSPRÜFGERÄT

JT 777
JEDEC TESTER FÜR DIODEN

KKM 740
KABEL- KAPAZITÄTS- MESSGERÄT

KML 710
SPERRSPANNUNGSMESSGERÄT FÜR LEISTUNGSHALBLEITER

KTM 604
KAPAZITÄTSTOLERANZMESSBRÜCKE FÜR GROSSE LEISTUNGSKONDENSATOREN

LCM 625
LECKSTROMMESSGERÄT FÜR IGBTS UND MOS-TRANSISTOREN

LRT 640
Widerstandsmessgerät für Niederohm-Widerstände

LRT 703
LOW RESISTANCE TESTER

MLH 634
MESSGERÄT FÜR LEISTUNGSHALBLEITER

MU 625
MESSSTELLENUMSCHALTER

MU 746
Der Messstellenumschalter MU 746 ist ein wesentlicher Bestandteil des Messsystems für Leistungshalbleiter TSP 746. Er di...

SML 664
SPERRSPANNUNGSMESSGERÄT FÜR LEISTUNGSHALBLEITER
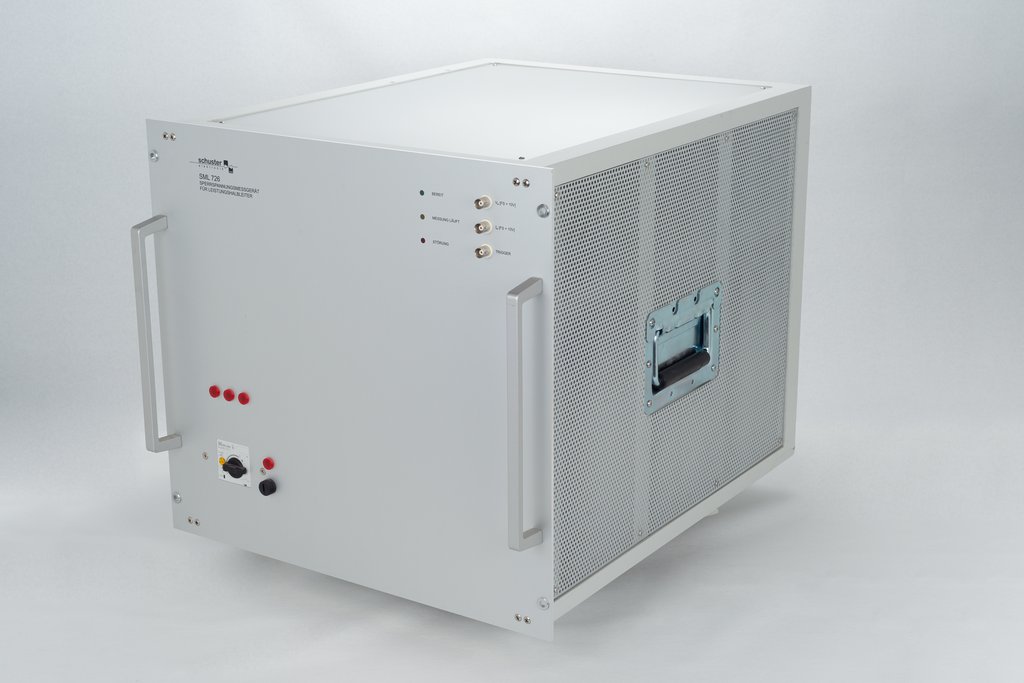
SML 726
SPERRSPANNUNGSMESSGERÄT FÜR LEISTUNGSHALBLEITER

STS 717
TESTSYSTEM FÜR LEISTUNGSHALBLEITER

STS 805
TESTSYSTEM FÜR LEISTUNGSHALBLEITER
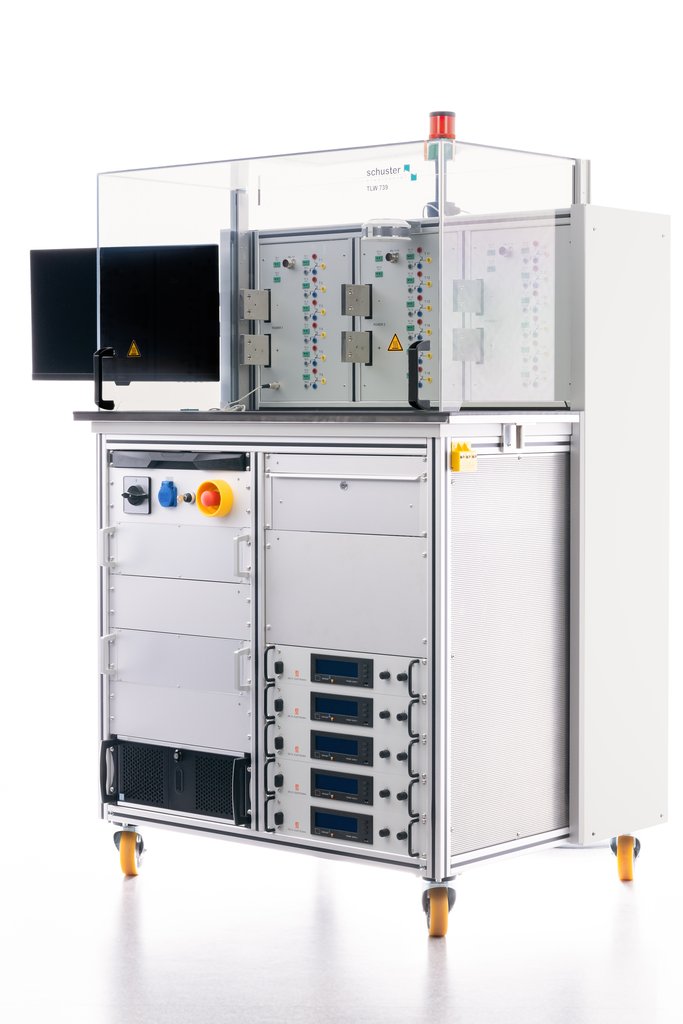
TLW 739
TESTSYSTEM FÜR LASTWECHSELFESTIGKEIT VON HALBLEITERMODULEN

TLW 763
TESTSYSTEM FÜR LASTWECHSELFESTIGKEIT VON HALBLEITERMODULEN
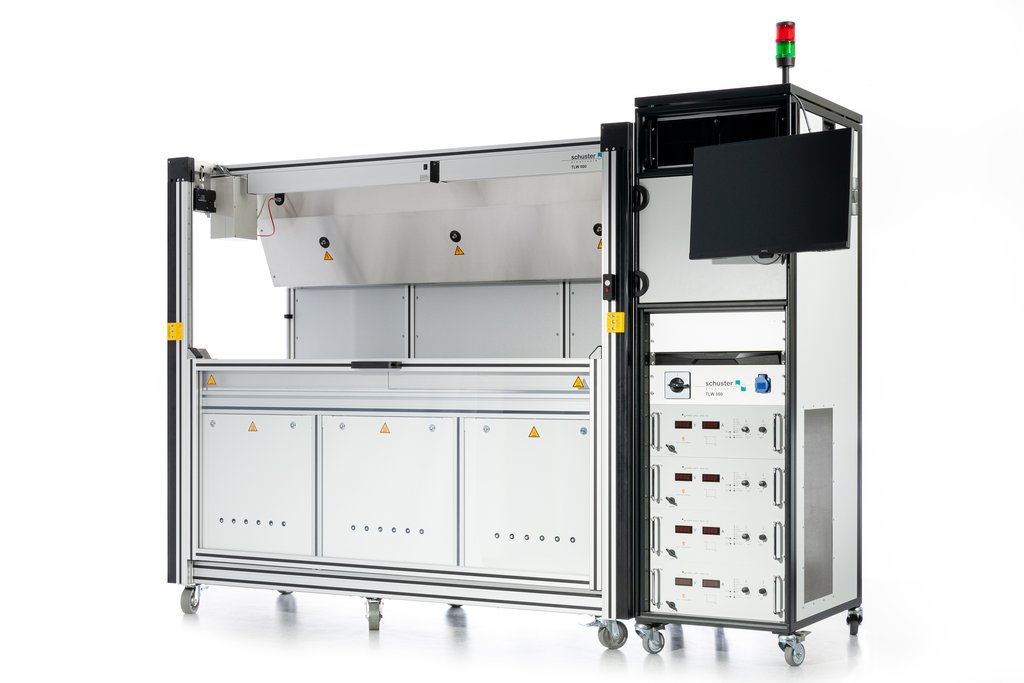
TLW 800
TESTSYSTEM FÜR LASTWECHSELFESTIGKEIT VON HALBLEITERMODULEN

TLW 813
TESTSYSTEM FÜR LASTWECHSELFESTIGKEIT VON HALBLEITERN
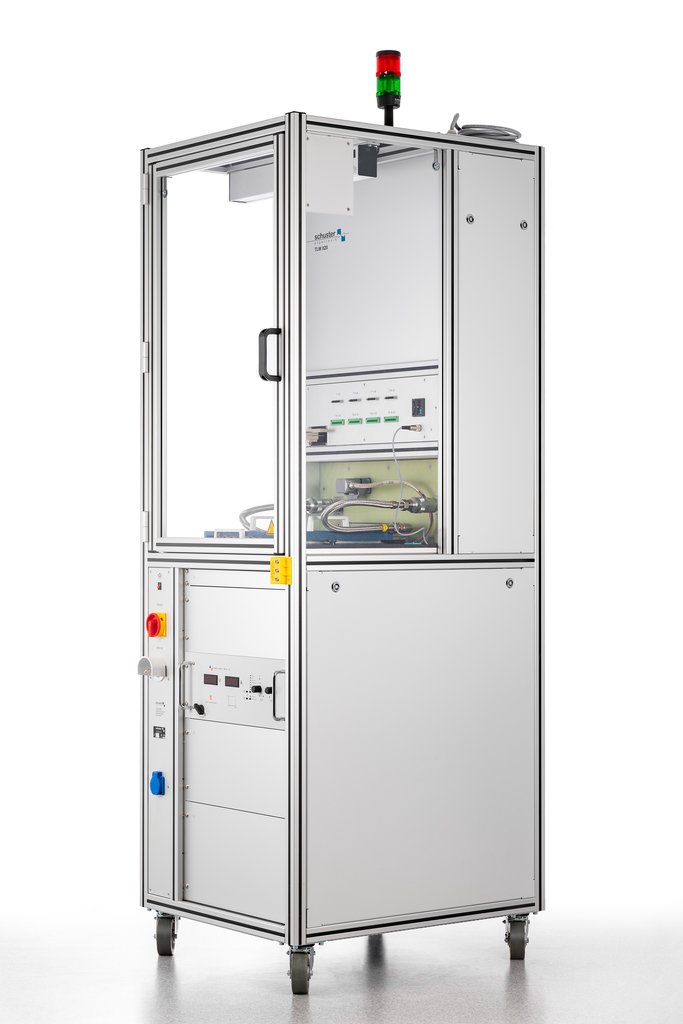
TLW 820
TESTSYSTEM FÜR LASTWECHSELFESTIGKEIT VON HALBLEITERMODULEN

TPS 625
PRÜFSYSTEM FÜR LEISTUNGSHALBLEITER

TPS 746
PRÜFSYSTEM FÜR LEISTUNGSHALBLEITER
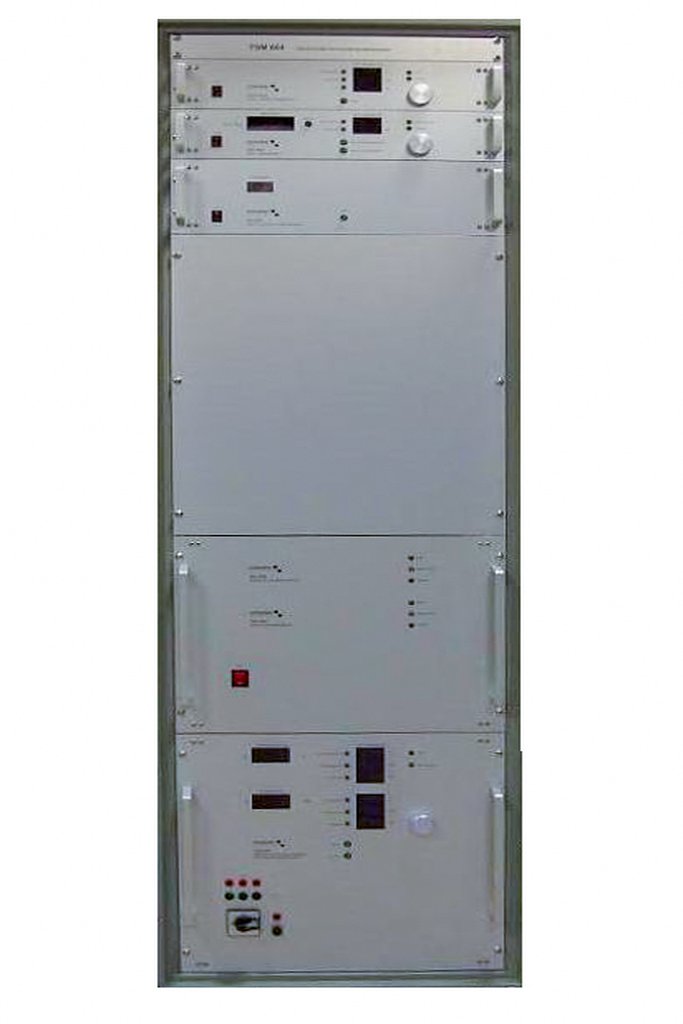
TSM 664
TESTSYSTEM FÜR STATISCHE MESSUNGEN AN LEISTUNGSHALBLEITERN

TSM 738
Prüfsystem für Leistungshalbleiter

WM 694
WÄRMEWIDERSTANDSMESSGERÄT FÜR LEISTUNGSHALBLEITER

ZEH 634
ZÜND-, EINRAST- UND HALTESTROM- MESSGERÄT
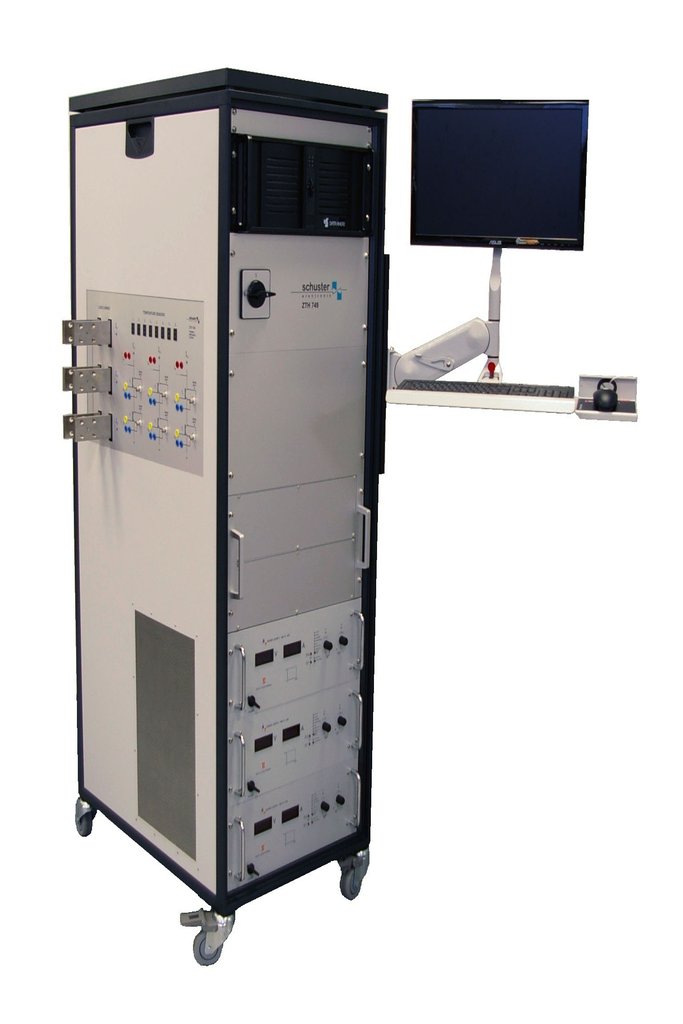
ZTH 749
WÄRMEWIDERSTANDSMESSPLATZ FÜR LEISTUNGSHALBLEITER
| Bezeichnung | Beschreibung |
|---|---|
| BVM 625 | SPERRSPANNUNGSMESSGERÄT |
| BVM 729 | BVM 729 Kennlinienmessgerät |
| BVM 738 | SPERRSPANNUNGSTESTER FÜR LEISTUNGSHALBLEITER |
| DM 659 | DM 659 Durchlass-Kennlinienmessgerät |
| DM 678 | DURCHLASSMESSGERÄT UND MESSSTELLENUMSCHALTER |
| DM 714 | DURCHLASSMESSGERÄT |
| DM 725 | DURCHLASSMESSGERÄT |
| DM 736 | DURCHLASSMESSGERÄT |
| DM 821 | DURCHLASSMESSGERÄT |
| DQA 775 | DURCHLASS-, GATE-LADUNGS-, UND AVALANCHE-MESSGERÄT |
| DT 616 | DT 616 Diodenprüfgerät |
| DTS 761 | TESTSYSTEM FÜR DYNAMISCHE EIGENSCHAFTEN VON LEISTUNGSHALBLEITERN |
| DVDT 736 | PRÜFGERÄT FÜR dv/dt – VERHALTEN VON THYRISTOREN |
| FVM 625 | DURCHLASSMESSGERÄT |
| GSG 664 | GATE-STRESS-GENERATOR |
| HTRB 689 | PRÜFANLAGE FÜR HOCHTEMPERATUR-SPERR-LAGERUNG |
| HTRB 782 | PRÜFANLAGE FÜR HOCHTEMPERATURSPERRLAGERUNG |
| HTRB 784 | PRÜFANLAGE FÜR HOCHTEMPERATURSPERRLAGERUNG |
| IP 625 | ISOLATIONSPRÜFGERÄT |
| IP 630 | ISOLATIONSPRÜFGERÄT |
| JT 777 | JEDEC TESTER FÜR DIODEN |
| KKM 740 | KABEL- KAPAZITÄTS- MESSGERÄT |
| KML 710 | SPERRSPANNUNGSMESSGERÄT FÜR LEISTUNGSHALBLEITER |
| KTM 604 | KAPAZITÄTSTOLERANZMESSBRÜCKE FÜR GROSSE LEISTUNGSKONDENSATOREN |
| LCM 625 | LECKSTROMMESSGERÄT FÜR IGBTS UND MOS-TRANSISTOREN |
| LRT 640 | Widerstandsmessgerät für Niederohm-Widerstände |
| LRT 703 | LOW RESISTANCE TESTER |
| MLH 634 | MESSGERÄT FÜR LEISTUNGSHALBLEITER |
| MU 625 | MESSSTELLENUMSCHALTER |
| MU 746 | Der Messstellenumschalter MU 746 ist ein wesentlicher Bestandteil des Messsystems für Leistungshalbleiter TSP 746. Er di... |
| SML 664 | SPERRSPANNUNGSMESSGERÄT FÜR LEISTUNGSHALBLEITER |
| SML 726 | SPERRSPANNUNGSMESSGERÄT FÜR LEISTUNGSHALBLEITER |
| STS 717 | TESTSYSTEM FÜR LEISTUNGSHALBLEITER |
| STS 805 | TESTSYSTEM FÜR LEISTUNGSHALBLEITER |
| TLW 739 | TESTSYSTEM FÜR LASTWECHSELFESTIGKEIT VON HALBLEITERMODULEN |
| TLW 763 | TESTSYSTEM FÜR LASTWECHSELFESTIGKEIT VON HALBLEITERMODULEN |
| TLW 800 | TESTSYSTEM FÜR LASTWECHSELFESTIGKEIT VON HALBLEITERMODULEN |
| TLW 813 | TESTSYSTEM FÜR LASTWECHSELFESTIGKEIT VON HALBLEITERN |
| TLW 820 | TESTSYSTEM FÜR LASTWECHSELFESTIGKEIT VON HALBLEITERMODULEN |
| TPS 625 | PRÜFSYSTEM FÜR LEISTUNGSHALBLEITER |
| TPS 746 | PRÜFSYSTEM FÜR LEISTUNGSHALBLEITER |
| TSM 664 | TESTSYSTEM FÜR STATISCHE MESSUNGEN AN LEISTUNGSHALBLEITERN |
| TSM 738 | Prüfsystem für Leistungshalbleiter |
| WM 694 | WÄRMEWIDERSTANDSMESSGERÄT FÜR LEISTUNGSHALBLEITER |
| ZEH 634 | ZÜND-, EINRAST- UND HALTESTROM- MESSGERÄT |
| ZTH 749 | WÄRMEWIDERSTANDSMESSPLATZ FÜR LEISTUNGSHALBLEITER |
Haben Sie Fragen?
Wir beraten Sie gerne zu unseren Messgeräten und Prüfsystemen.